● DUV発生とは...

リソグラフィとは、マスクに描かれた回路パターンをレジストに焼き付ける工程である。DRAMのハーフピッチ32 nm以細のリソグラフィ光源として、中心波長13.5 nmのEUV光が有力視されている。
本研究ではEUVリソグラフィ光源として、回転Sn貫通光ターゲットを提案した。発生した光は貫通方向で積算され高輝度となる。発光後のSnは貫通孔の内壁に衝突して再付着するので、デブリフリーのEUV光源が期待できる。
実験装置の概略を示す。励起用レーザーには,波長1064nm、エネルギー500mJ/pulseのNd:YAG レーザーを用い、貫通孔入口に集光照射した。レンズを用いた。貫通孔ターゲットは、マイクロドリル(直径200 μm)を用いて作成した。
波長13.5 nm近傍のEUVを計測するための小形検出器は①Siウェハ平滑表面にAuをスパッタ蒸着して形成した1枚のミラー、②Zrフィルタ(Lebow製)、③EUV検出用Siフォトダイオード(IRD製SXUV HS5–Mo/ Si)から構成されている。
EUV検出器を後方0°から斜め40°の角度まで2~5°毎に回転させながらエネルギー500 mJ/pulseのレーザー照射実験を繰返し、EUV強度の角度分布をプロットした。結果から、貫通孔ターゲットは強い指向性を持つことが分かる。
励起レーザーのパルス幅を4~8ns、エネルギーを270~660mJで3段階変えて計測した結果を示す。①から④までの実験結果でパルス幅に依存した結果と考えられたが、⑤データより、他の要因で変化が現れていることが分かった。
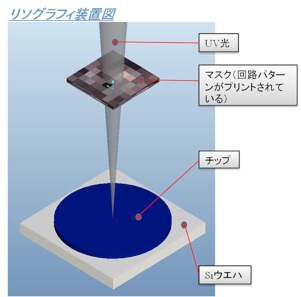
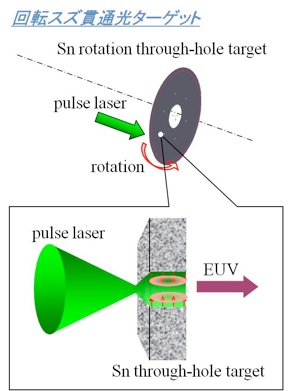
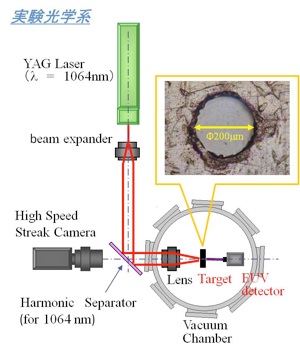
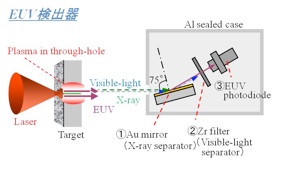
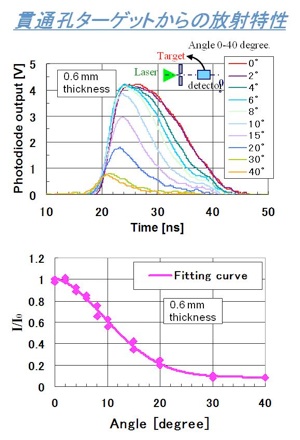
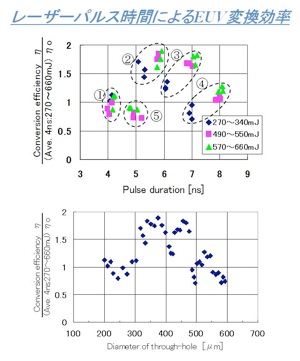
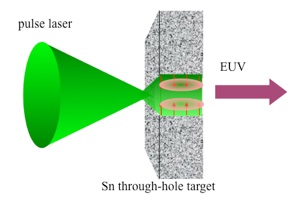
国際半導体技術ロードマップでDRAMのハーフピッチ32 nm以細の世代は、中心波長13.5 nmの極端紫外(EUV: Extreme ultraviolet)光を用いたリソグラフィ装置の利用が最も有望な技術として挙げられている。プラズマ光源から放射されるEUV光はブロードな角度特性を持つため、集光光学系によって一旦中間集光点に集められて利用される。商用のEUV光源には中間集光点で光パワー115 W以上の高輝度と7~10 kHzの高い繰り返しレートで1年間運転可能という長寿命が要求されている。
